Board to board connected PWB
板間接合基板
不要な貫通ビアをIVHに置き換えて、従来制約を受けていたエリアへの配線が可能となり、配線設計自由度と配線収容能力が向上。
また、超高多層化や板厚10mm以上にすることも実現可能です。
Product Outline概要
- 穴径の小径化が可能となり、穴間の配線収容量が増加
- 配線設計可能領域の増加により、配線設計自由度が大幅に改善
- 高板厚化が容易
- MWB(マルチワイヤ配線板)で実現不可能な信号線の高密度化に成功
- IVHスタブを最小限に抑え、高速化を実現。
また、インナーバックドリルとの組合せにより更なる高速化に対応
製造拠点:下館工場
Features特徴
01配線設計の自由度が向上、
配線収容量も大幅に増加
貫通ビアをIVHに置き換えることにより穴径を小さくすることが可能となり、穴間に通る配線の本数を増やすことができます。また、不要な貫通ビアを削減(必要な部分のみIVHに置き換え)することで、配線設計可能領域を増やし、配線設計自由度も大幅に改善することに成功しました。

02高速化を実現した
IVHのスタック構造・インナー
バックドリルの組合せ
IVHをスタック構造に配置する本技術では、従来の貫通ビアで発生したスタブを最小限に抑えることが可能となり、高速化を実現しました。さらにインナーバックドリルとの組合せにより、更なる高速化対応が可能となります。
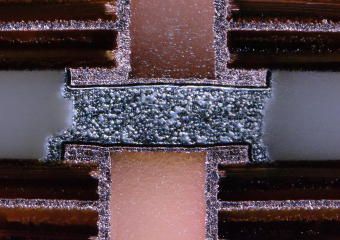
03従来の製造プロセスでは
実現できなかった基板の
超高多層・高板厚化が可能
製造設備や製品仕様(穴径、銅めっき等)の制約により、これまでは最大板厚が7.7mmまででした。そこで、子基板を先に作製し、導電性ペーストで子基板同士を接合することで、本技術では7.7mmを超える板厚が実現可能となりました。同時に100層を超える超高多層基板も製造可能となりました。

04環境にやさしいプロセス
従来の貫通ビアとIVHが混在する配線板に比べ、IVHのみで形成される板間接合基板は銅めっき処理回数を低減できます。また、子基板完成時に電気検査を実施することにより、早い段階で不良基板を見つけて廃棄することで廃棄量の削減につながり、環境にやさしいプロセスとなっています。

Technology Roadmap技術ロードマップ
MWB(マルチワイヤ配線板)を使用した場合
※表は左右にスクロールして確認することができます。
| 項目 | 2024 | 2025 | 2026 | |
|---|---|---|---|---|
| 接合数 | 2枚接合 |
≦ t7.4mm |
||
| 3枚接合 |
≦ t7.4mm |
≦ t12.0mm |
||
| 最小ピッチ接合 |
0.80mm |
0.65mm |
||
| 配線密度 |
2 wires / 0.8mm , 1 wire / 0.65mm (Φ0.065 wire) |
|||
|
2wires/0.7mm (Φ0.050 wire) |
||||
| 最小ドリル径 |
Φ0.25 (Φ0.065 wire) |
|||
|
Φ0.20 (Φ0.050 wire) |
||||
MLB(高多層高密度配線板)を使用した場合
※表は左右にスクロールして確認することができます。
| 項目 | 2024 | 2025 | 2026 | |
|---|---|---|---|---|
| 接合数 | 2枚接合 |
≦ t7.4mm |
||
| 3枚接合 |
≦ t7.4mm |
≦ t12.0mm |
||
| 最小ピッチ接合 |
0.80mm |
0.65mm |
||
| 最小ドリル径 |
Φ0.20 |
Φ0.15 |
||
おもな用途
プローブカード

半導体の製造工程で、ウェハーの品質検査に用いられる器具です。半導体需要に合わせて、検査精度の重要性は増しています。リンクステックのプリント配線板は、半導体の検査工程でトップシェアを得ています。

