- TOP
- リンクステックのつよみ
- 銅バンプ付きプリント配線板の開発でモジュールの小型化を実現
Development Story3
銅バンプ付きプリ
ント配線板の開発
で
モジュールの
小型化を実現
The introduction of
substrate has導入成果
- 半導体チップを配線板の表裏に実装することで、回路設計の自由度を向上
- モジュールの省スペース化と多機能化を実現
- 接続信頼性と放熱特性が従来品より改善し、
半導体チップの熱対策に貢献
Background of development開発背景
スマートフォンの高機能化ニーズに応じる
モジュールの多機能化・縮小化が必要に

近年、スマートフォンの高機能化に伴い、内部モジュールのさらなる多機能化が求められています。一方でバッテリーの容量やサイズは増大しており、モジュールの搭載スペースは縮小しています。多機能化を実現しつつ、より小さなスペースにモジュールを配置しなければならないという課題への解決策の1つが、マルチチップモジュール化を可能にする配線板の活用です。
マルチチップモジュール化の実現のためにリンクステックが開発した製品が、銅バンプ付きプリント配線板です。
Problems and solutions課題と解決策
銅バンプ付きプリント配線板が
モジュール配線板の小型化を実現
銅バンプ付きプリント配線板は、外部端子として銅バンプを形成することで、外部端子とチップ実装を同一面に設計可能にしたプリント配線板です。半導体チップを配線板の表裏に実装することで、モジュールの省スペース化と多機能化を同時に実現できます。
従来のモジュールは、メイン基板とモジュールを接続する外部接続端子に、形状制御が困難なはんだボールを用いるため、メイン基板とモジュール間の高さや、外部端子間の距離の設計に制約がありました。
銅バンプ付きプリント配線板の場合、パターン銅めっきを応用した技術により0.01mm単位での形状調整が可能です。その結果、外部端子とチップ実装を同一面に設計したり、バンプピッチの高密度化(最小ピッチ0.31mm)を図ったりするなど、回路設計の自由度を向上できます。
マルチチップモジュール配線板
小型化イメージ図
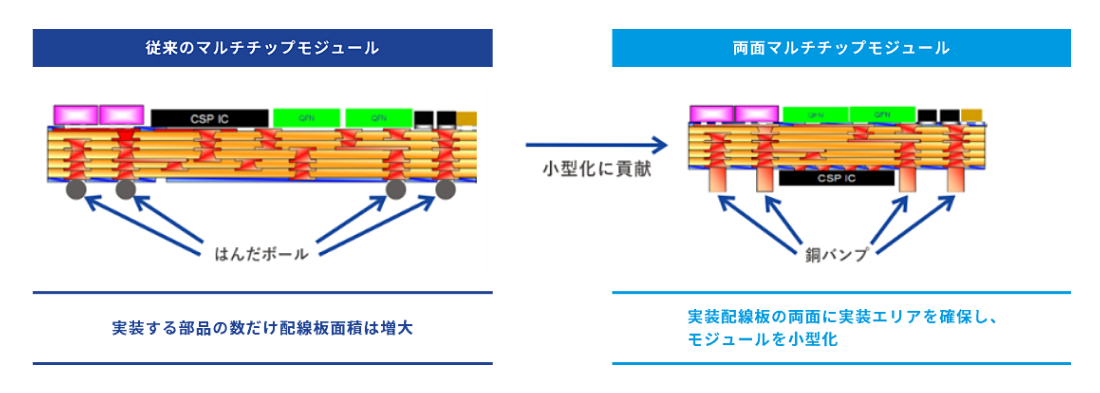
接続信頼性と放熱特性の高い
マルチチップモジュールが誕生
はんだと銅の放熱特性比較(参考値)
※表は左右にスクロールして確認することができます。
| 物質 | 測定温度 [K] |
比熱 [J/(kg・K)] |
熱伝導率 [W/m・K] |
熱膨張係数 [10-6/K] |
バンプ接合強度 [g/φ0.22mm] |
|---|---|---|---|---|---|
| 銅 | 293 | 419 | 372 | 17.7 | 430 |
| はんだ Sn-50Pb |
293 | 176 | 49 | ー | ー |
銅バンプと銅回路の結合